铜核球抗坍塌性能:电子封装领域的结构稳定性革命
在电子制造领域,多次回焊工艺对元件结构稳定性构成严峻挑战,传统锡球在多次回流条件下易因焊点熔融出现坍塌问题,导致电路短路及产品可靠性问题。而铜核球(CCSB)通过其独特的结构创新为高密度封装技术带来突破,其核心优势在于铜核芯具备1083℃的超高熔点,远高于常规回焊温度,在多次回流过程中能保持固态不变形,为焊点提供坚实支撑,有效防止上级焊点熔融导致的塌陷,从而保障电子元件在密集封装条件下的结构完整性和功能可靠性,成为推动微电子封装技术革新的关键解决方案。
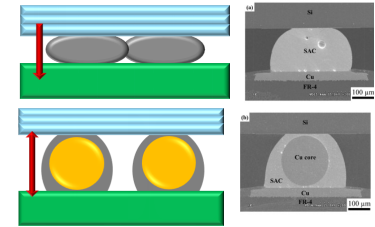
一、“三明治”结构的固态支撑奥秘
铜核球(CCSB)采用独特的“三明治”结构,由三大核心层构成:
铜核芯(50-800μm):作为力学支撑的“骨骼”,采用高纯度铜材制成,熔点高达1083℃,在常规回焊工艺(200-260℃)中始终保持固态不变形,这意味着在回焊过程中,铜核芯能够保持固态,不会发生熔融变形。
镀镍层(2-5μm):作为界面稳定的“纽带”,通过镀镍工艺在铜核芯表面形成致密镍层,不仅增强了铜核球的机械强度,还有效防止了铜与钎料之间的直接接触,从而避免了铜和焊料层生成金属间化合物(IMC),导致可靠性降低。
外镀层(5-50μm):作为功能实现的“皮肤”,根据应用需求可选择Sn、Au、SC/SAC/SA 等镀层,提高焊接性能,而内部铜核芯的固态支撑则确保焊点在冷却后保持稳定形态。

二、核心应用优势
1. 高密度3D封装
在高密度3D封装中,铜核球(CCSB)的抗坍塌性能尤为重要。由于3D封装需要在有限的空间内集成更多的电子元件,焊点的稳定性直接关系到整个封装结构的可靠性。铜核球(CCSB)的高熔点和良好的机械性能使其能够在多次回焊过程中保持稳定,为高密度封装提供了可靠的解决方案。
2. 窄间距封装
随着电子元件的小型化,窄间距封装成为了一种趋势。铜核球(CCSB)的抗坍塌性能使其能够在窄间距封装中保持焊点的稳定性和可靠性。与传统的锡球相比,铜核球(CCSB)在回焊过程中不会发生坍塌,从而避免了焊点之间的短路和封装空间的变窄。
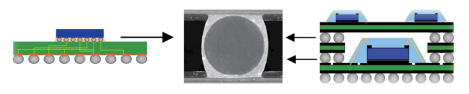
三、抗塌技术革新
铜核球(CCSB)的抗坍塌性能为电子封装领域注入了全新活力。在回焊场景下,其凭借高熔点特性彻底攻克了传统锡球焊点熔融坍塌的行业难题,从根本上提升了焊点的稳定性与可靠性,成为电子元件结构安全的稳固基石。
从技术革新维度审视,铜核球抗坍塌性能的突破不仅是一次工艺升级,更标志着电子封装领域向高性能、小型化目标迈出关键一步。随着技术迭代的持续推进,这一创新解决方案有望在更多前沿应用场景中释放潜力,持续引领行业向更高可靠性、更精密集成的方向革新发展,值得行业持续关注与期待。
地址:珠海市横琴新区荣珠道191号写字楼2106房
中国河南省洛阳市宜阳产业集聚区电子电器工业园1号
电话: 0756-6831190
0379-68950718
手机:13333896565(微信同号)
13532262175(微信同号)
邮箱:caojiangwei@jinnho.com
tristawang@jinnhoo.com
0379-68950718
+8613333896565
+8613532262175

